分析机构trendforce集邦咨询近日披露,全球三大hbm内存制造商已决定在hbm5 20hi世代采纳混合键合hybrid bonding技术。此项技术革新旨在应对堆叠高度、i/o密度及散热等多方面挑战。
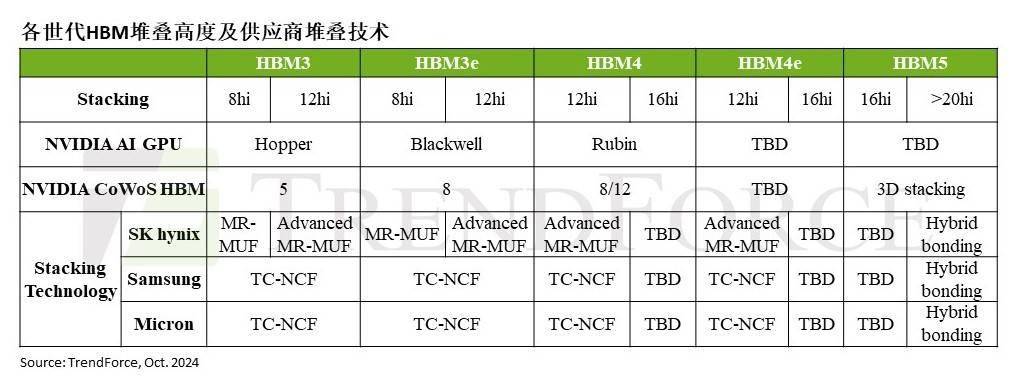
据悉,sk海力士、三星电子及美光科技在hbm4与hbm4e两代产品中将分别推出12hi和16hi版本,以满足市场对不同容量的需求。其中,12hi版本将继续沿用现有的微凸块键合技术,而16hi版本的技术路径则尚待确认。
英伟达未来的ai gpu预计将采用与hbm5内存3d堆叠的集成方式,而非现行的2.5d方式,这一变化预示着内存技术的新趋势。
混合键合技术因其无凸块设计,不仅可容纳更多堆叠层数和更厚的晶粒,从而改善芯片翘曲问题,还能显著提升传输速度和散热性能。然而,该技术仍面临微粒控制等挑战。
对于hbm4(e)16hi产品是否采用混合键合技术,制造商面临两难选择:一方面,提前引入新技术可加速学习曲线并确保hbm5 20hi的顺利量产;另一方面,这也意味着需要额外的设备投资,并可能牺牲在微凸块键合技术上的部分优势。
混合键合的晶圆对晶圆(wow)堆叠模式对生产良率提出了更高要求,并可能导致dram芯片尺寸与底部base die相同,这一变化可能使台积电等具备先进base die生产与wow堆叠能力的企业在hbm生产中扮演更重要角色,进而改变整个hbm加先进封装的商业模式。














